他们都在搜: 3D弹片SMT008004VCM20252024
0513-81196610
电话:13656269491
传真:0513-81196630
邮箱:mef@micro-ef.com
地址:南通苏通科技产业园江荣路10号
目前,业界有几种技术可用于在晶圆的焊垫上涂敷焊料混合物,这种技术被称之为晶圆凸起工艺。采用网板印刷进行晶圆凸起加工,作为一种可节省成本的大批量生产方案,而广受欢迎。但随着I/O数目增加和间距不断缩小,这种使用网板在焊点上印刷焊膏的方法变得更有挑战性,与之匹配的工艺设计水准要求也大大提高。

为何采用网板印刷方法?
业界三种最著名的晶圆凸起方法—网板印刷、蒸发及溅射或电镀,各有其优缺点(表一)。选择何种方法,除了需要考虑公司的工艺路线图,更重要的是需要考虑众多的参数,包括凸起间距、凸起高度、晶圆基底材料、晶圆厚度、晶圆尺寸、凸起一致性,以及凸起材料。

设备和材料
晶圆凸起印刷方法的设计,与标准表面安装装配生产线的工具兼容,所以在升级或改造现有的大型设备时无需额外的投资。
然而,网板印刷机应配备精密的光学装置。对位系统应当能够识别所处理晶圆上的非标准参考点,包括焊垫边角、特殊标志、标记,或其它与背景覆盖物对比鲜明的金属化特征。
在印刷过程中,为了确保安全地处理精密的晶圆,需要使用刚性托盘来支持晶圆。
晶圆凸起通常使用水溶性焊膏。凸起必须清洁,易于随后的倒装芯片装配过程中进行助熔处理,以达到稳定的润湿和一致的粘结;另外,最大限度地减少在凸起上或凸起之间积聚的任何残余物,可使装配后倒装芯片底部充胶工艺更为可靠。至今,市场上尚无能够实现无残余物焊点的商业用非清洁型焊膏材料。
工艺步骤
晶圆凸起印刷
工艺与 FR-4 基底上进行印刷是相似的。首先将晶圆放置在托盘上,通过传送带传送至网板印刷机;然后,对于刮刀印刷方式,先将焊膏搅动30至60秒,准备好以便进行装填,这是均匀地涂敷助焊剂和焊锡粉,并将焊膏稀释至合适稠度的重要步骤,(使用具有自动灌注和搅和焊功能的卡盒式封闭印刷头系统,这个步骤可以省去);接着,将焊膏涂敷到网板上之后,印刷机的视像系统就查找所有的参考点,在整个网板表面清洁地擦拭焊膏,将其注入所有的开孔中;最后,托盘和晶圆从印刷机中传送出来。
定位校验
采用显微镜进行焊膏沉积定位校验,焊膏沉积物应正确对位以覆盖所有焊垫,这是保证稳固的回流焊工艺的关键要素。对于高密度的精细间距配置,实现完美的印刷对位是颇具挑战性的任务,有时需要对手动偏移对准位置进行编程。
回流焊
一旦完成焊膏对位的校验,已印好的晶圆就可在强制对流型炉中进行回流焊。
清洗和烘干
在清洁工序中,用温和的去离子水清洗晶圆,除去水溶性助焊剂。然后用清洁的强制对流空气或氮气烘干晶圆。最后,建议对晶圆进行两小时的125℃脱水烘焙,去除晶圆在清洗过程中可能吸收的任何水分。
清洁网板
网板的清洁度也是至关重要的,即使在单次印刷行程后,网板开孔内壁也会积聚不少的焊膏残余物,它会很快变干并玷污后来的印刷行程。
影响晶圆凸起良率的工艺参数
许多变量会严重地影响采用这种凸起方法的晶圆的质量或良率。通常用已知好裸片(known good die, KGD)数值来表示晶圆凸起工艺的性能。成功实施晶圆印刷工艺需考虑的最重要因素包括:焊膏、印刷环境 (环境和湿度)、印刷机设置、回流焊状况以及清洁选项。
焊膏
焊膏的一个重要特性是颗粒尺寸和分布,这主要取决于焊膏沉积的数量要求,以及网板开孔的大小。一般认为,焊膏的颗粒分布应是能让至少三个最大的焊球直径符合网板上最小开孔的宽度,这就是有名的“三球定律”。焊料颗粒的分布和密度直接影响焊膏的流变特性,也影响其在网板印刷机上的性能。
在进行晶圆网板印刷时,最好使用最精细的焊料粉末;据报道 Sn63/Pb37 V 型焊膏颗粒分布的金属含量达 90%,可有效地用于 8 mil 间距焊垫凸起加工,凸起高度达到 5 mil。
用于晶圆印刷的焊膏,其暴露时间和有效寿命周期的限制都比 SMT 焊膏的标准值短。为了使焊膏的寿命周期达到最大值,只要印刷机处于空闲状态,就应当将焊膏从网板上移开。使用封闭转印制的一个重要优势是焊膏总是处于封闭状态,并与周围环境相隔离。
温度和湿度
环境的主要影响是水分会被吸收进组件、基底,特别是焊膏中。对比非清洁型焊膏,水溶性晶圆凸起焊膏对这些环境变化更为敏感。如果相对湿度水平超过60%,水分便会进入水溶性焊膏中;相反,如果相对湿度低于40%,则会引起焊膏过早变干。无论哪种情况,都会改变焊膏的印刷性能,网板印刷工艺也会大大偏离正常,成为装配工艺中受影响最大的环节。建议将温度保持在21℃至25℃之间,相对湿度水平维持在40% 和60% 之间;并且与设置点的偏差应尽可能减小。
印刷机设置
如今的网板印刷机提供多种印刷压力、速度和分离速度,加上可以选择数种不同的印制头装备和许多现代化的焊膏配方,使得精选合适的印刷参数成为一项并不简单的工作。
封闭式印制头的出现为晶圆凸起工艺带来重大的益处。对于这类焊膏涂敷系统,可接受的工艺窗更广阔,允许设置范围更大的印刷参数,从而更好地控制印刷介质的整体环境,以获得高质量的印刷结果。金属成分较高的焊膏可用于这类系统,施加独立的涂敷力,将焊料合金材料直接注入网板开孔中,获得更完美的焊膏涂敷形状。一般地,应在焊膏上施加足够大的直接压力,以形成良好的涂敷点,而没有多余的焊膏溢出。擦拭器的压力恰好足够即可,这样可在整个印刷过程中维持网板表面的清洁。如果需要,可将印制头的速度提高至超出刮刀印刷方法的限制,仍可获得良好的印刷清晰度。
回流炉配置
标准表面安装装配线的回流炉适合于在晶圆表面形成坚固的球形凸起。业界认为带有顶部和底部氮气环境加热装置并具有低氧PPM水平的强制对流回流炉,可提供最优的性能。传导回流炉也可理想地应用于晶圆加工。
回流炉变量可能影响晶圆良率和缺陷水平,但目前有关的实验信息还相当有限。有观点称,回流焊工艺的稳固性可能与焊膏的大小和定向有关。而且,湿焊膏覆盖焊垫的百分比越高,在回流焊过程中阻力特性就越好,焊膏越容易在焊垫上形成正确的球形。
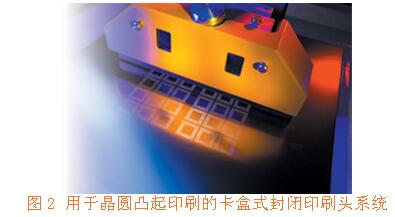
回流焊工艺参数包括预热快速升温,以达到150℃ ±10℃的助焊剂活化温度平台,接着是急剧跳至220℃ ±10℃,高于合金的液态温度,最后是快速冷却阶段(这是对Sn63/Pb37合金的建议)。在回流焊过程中,晶圆在每个温度区域的停留时间是相当重要的,应当根据焊膏供应商提供的技术规格,精确地控制温度上升/下降速率。
去除助焊剂残余物
回流焊和清洗之间的时间间隔越长,去除助焊剂的困难就越大。
成功实施网板印刷晶圆凸起工艺,需要提高与之匹配的材料(如焊膏、网板等)和工艺设计水准的要求。另外,影响晶圆凸起工艺的重要设计参数还包括:倒装芯片粘接焊垫设计、焊垫尺寸/形状、焊垫间距/定位、凸起下部金属化、托盘设计、网板设计、网板厚度、开孔尺寸/形状、开孔方向及开孔定位。只有深入了解影响这项工艺的众多设计策略,才能获得卓越的成果。
管理员刚刚
暂无任何留言!